
发布时间:2020-08-10
阅读量:989
BGA封装,即Ball Grid Array Package—球栅阵列封装,是高密度、多功能芯片常用的引脚封装,如下图所示,本文主要讲解如何对BGA封装利用HFSS进行仿真。1、当要对一个项目进行仿真时,需要先了解仿真项目有哪些参数尺寸、材料属性该如何设置、以及如何简化仿真模型等,不必一拿到仿真需求就去匆匆画图。如果能将仿真模型先在草稿上画上关键部分,成熟胸中,必能事半功倍,不然老要回头去修正模型,大大浪费时间。不啰嗦了,先来看看BGA封装的具体尺寸,如下图:可以从芯片的datasheet中找到具体的封装pad尺寸和BGA焊球的高度,其中这个高度和关键。
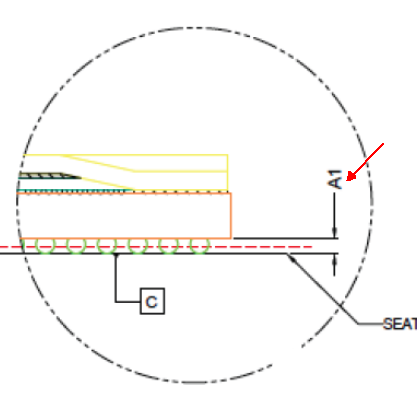
2、仿真准备工作,由于要通过TDR值来优化BGA过孔反焊盘的尺寸,需要将HFSS中的solution type设置为Terminal,即终端模式求解,另外扫频方式只能选择Interpolating(插值法扫描)。还有在HFSS》design setting中注意勾选Enable material override和automatically use causal material。(勾选这两项一是为了简化建模,让金属自动覆盖介质材料,因此不必额外再做减法substract;另一项是为了使得仿真求解满满足因果性,不然仿真结果容易出错)
3、建立模型,具体过程就不详述了,按BGA封装尺寸建立即可,如下图:在BGA焊球上方加一块pec以保证GND相连,wave port 2是一个100ohm的同轴差分线,可以通过Q2D来确定其尺寸和介质的介电常数。
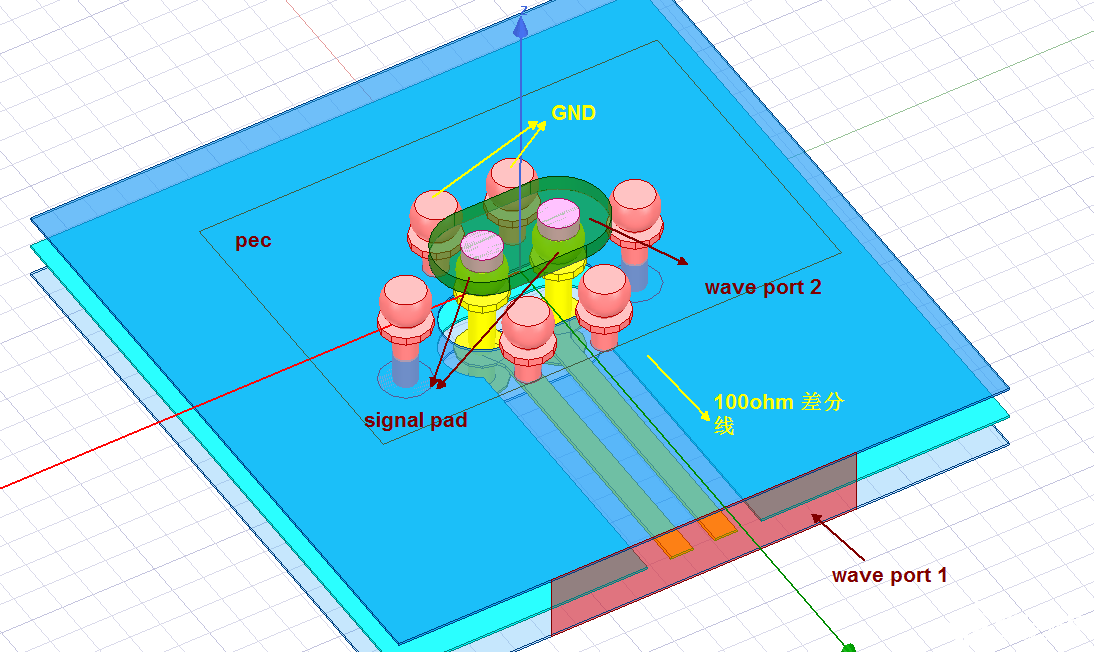
4、如果不想那么麻烦,wave port 2也可以用lumped port替代,缺点是端口不能deembed,deembed是HFSS简化模型的强大工具,但是仅仅针对wave port有效,lumped port也可以deembed,不过它的作用是消除lumped port的寄生电感,请注意这两个区别,lumped port模型如下图:
最后仿真的TDR如下:红色为优化的结果,但是还没到最佳,原因有二:第一、过孔有残桩且非功能焊盘没去掉;第二、过孔的反焊盘直径还比较小,可以继续加大,最佳的优化BGA+过孔阻抗在98ohm。

附录:使用Q2D确认100ohm差分同轴线的尺寸和介质介电常数。
BGA焊盘尺寸和位置是固定的,不能改动,只能优化绿色的介质半径R;
由于是同轴线,solution type要选择close;
介质材料需要设定为surface_GND;
使用reduce matrix设置差分diff pair,在matrix下查看当前的差分阻抗,接近100ohm即可;
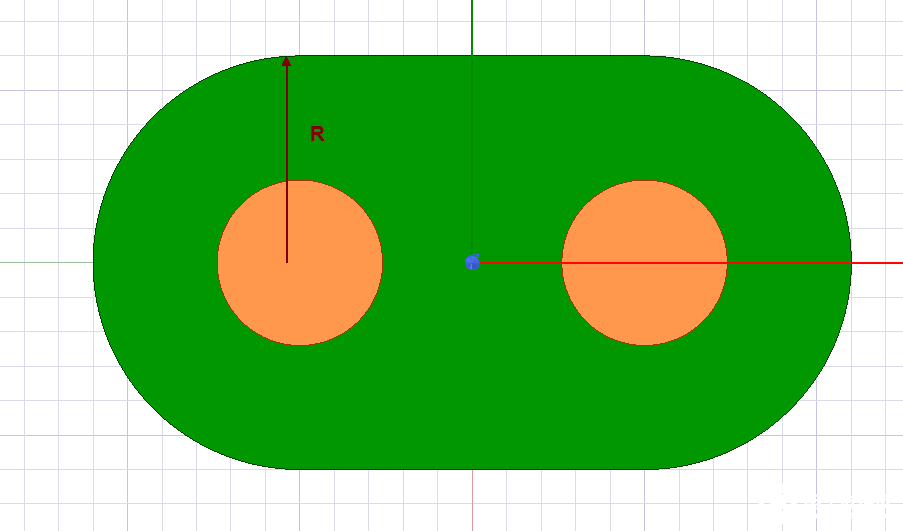
![]()